2000-IV
半导体分立器件 I-V 特性测试方案
泰克 TSP-2000-BAT 半导体器件测试方案
系统背景
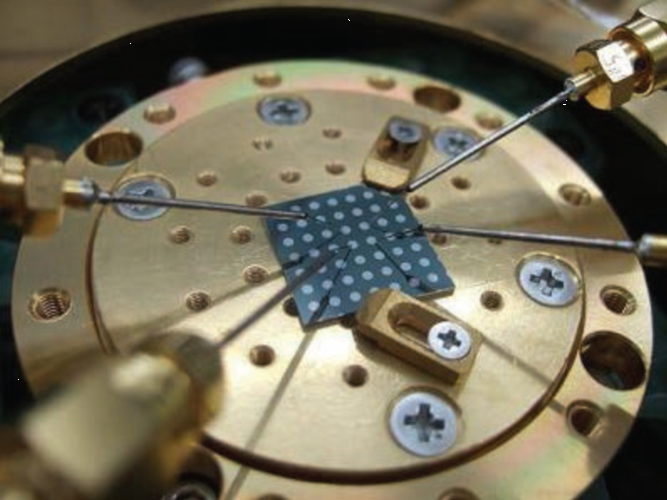
半导体分立器件是组成集成电路的基础,包含大量的双端口或三端口器件,如二极管,晶体管,场效应管等。直流I-V测试则是表征微电子器件、工艺及材料特性的基石。通常使用I-V特性分析,或I-V曲线,来决定器件的基本参数。微电子器件种类繁多,引脚数量和待测参数各不相同,除此以外,新材料和新器件对测试设备提出了更高的要求,要求测试设备具备更高的低电流测试能力,且能够支持各种功率范围的器件。
分立器件I-V特性测试的主要目的是通过实验,帮助工程师提取半导体器件的基本I-V特性参数,并在整个工艺流程结束后评估器件的优劣。
随着器件几何尺寸的减小,半导体器件特性测试对测试系统的要求越来越高。通常这些器件的接触电极尺寸只有微米量级,这些对低噪声源表,探针台和显微镜性能都提出了更高的要求。
半导体分立器件I-V特性测试方案,泰克公司与合作伙伴使用泰克吉时利公司开发的高精度源表(SMU)为核心测试设备,配备使用简便灵活,功能丰富的CycleStar测试软件,及精准稳定的探针台,为客户提供了可靠易用的解决方案,极大的提高了用户的工作效率。
方案特点
丰富的内置元器件库(双端口、三端口、MOSFET、BJT等),可以根据测试要求选择所需要的待测件类型;
四象限输出和测量功能,可以在正负电压、正负电流之间进行无缝切换和扫描;
测试和计算过程由软件自动执行,能够显示数据和曲线,节省了大量的时间;
精准稳定的探针台,针座分辨率可高达0.7um,显微镜放大倍数最高可达x195倍;
高达500fA电流输出分辨率和10fA测量分辨率,可以满足半导体器件微小电信号控制和测量要求。
测试功能
双端口、三端口器件直流参数测量;
I-V,I-T,V-T,I-R,V-R 扫描测试;
曲线绘制,原始数据导出,结果保存。
系统结构
系统主要由一台双通道源表或两台单通道源表(SMU)、连接线或探针台,及上位机软件构成。以三端口 MOSFET 或 BJT 器件为例,共需要以下设备:两台吉时利 2450 源表、三同轴或香蕉头连接电缆、夹具或探针台。
上位机软件与源表(SMU)的连接方式如下图所示,可以使用LAN/USB/GPIB中的任何一个接口进行连接。
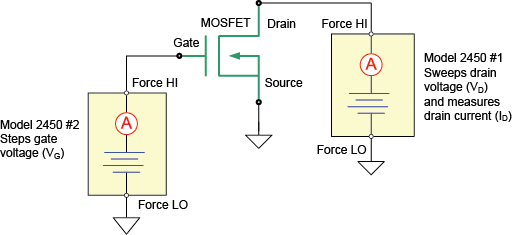
系统连接示意图
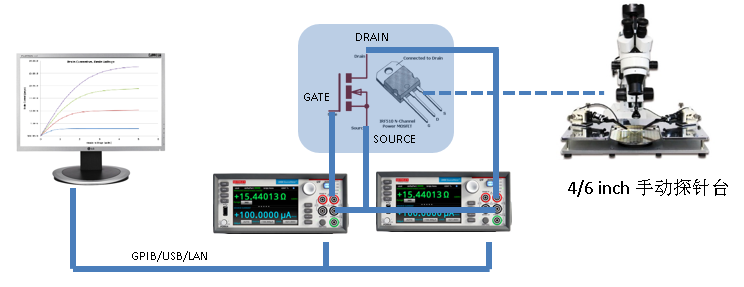
典型方案配置
源表 | 2450/2460/2461/2601/2602,吉时利源表 |
探针台 | EPS 400/600,4寸或6寸手动探针台 |
上位机软件 | CycleStar I-V 专业测试软件 |
系统典型参数
以两台2450组成的典型三端口I-V测试系统为例,参数如下表所示:
输出范围 | +/-200V,+/-1A,20W |
电压输出精度(20mV量程) | 最高0.015% + 200 μV |
电压测量精度(20mV量程) | 最高0.100% + 150 μV |
电流输出精度(10nA量程) | 最高0.100% + 100 pA |
电流测量精度(10nA量程) | 最高0.100% + 50 pA |






